普莱信智能发布新一代Fluxless TCB设备,引领CPO封装设备发展
2025-08-26
10:26:03
来源: 互联网
点击
普莱信智能正式发布其新一代的Fluxless TCB 设备 Loong Advance, 该设备采用甲酸还原系统,贴装精度高达±0.5微米,该设备将广泛应用于未来的CPO,2.5D,3D等先进封装和Cu-Cu键合工艺。
CPO作为一种革命性的光电集成技术,将传统分离的光学组件包括电子集成电路(EIC) 、光子集成电路(PIC)集成在同一封装基板或中介层(Interposer)上,便构成了光引擎(OE),它被安装在基板上的 ASIC 芯片周围。相较于传统可插拔光模块,CPO将能耗降低50%、延迟压至1纳秒内、信号完整性优化了18dB(63倍)、支持1.6T以上超高带宽、更高集成度等优势,正在高速数据中心、人工智能计算集群和通信网络等领域掀起变革浪潮。
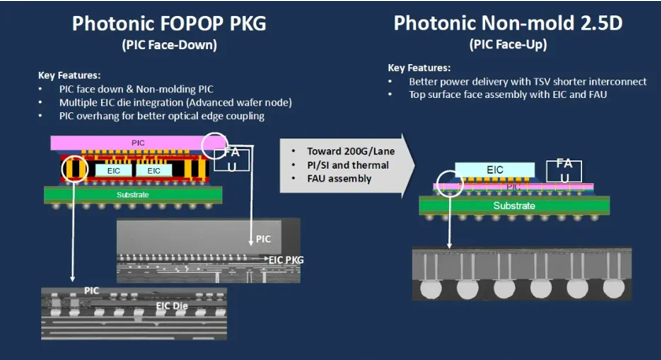
据权威机构预测,全球CPO市场规模从2024年4600万美元增至2030年81亿美元(年复合增长率137%)。
在当前的早期发展阶段,CPO面临热管理(3D堆叠温度>85℃)、封装良率(<85%)、成本高等瓶颈。CPO模块成本数千美元,封装制造占总成本的30%-50%+,需规模化降本,随着技术成熟和量产,这个比例有望大幅下降。
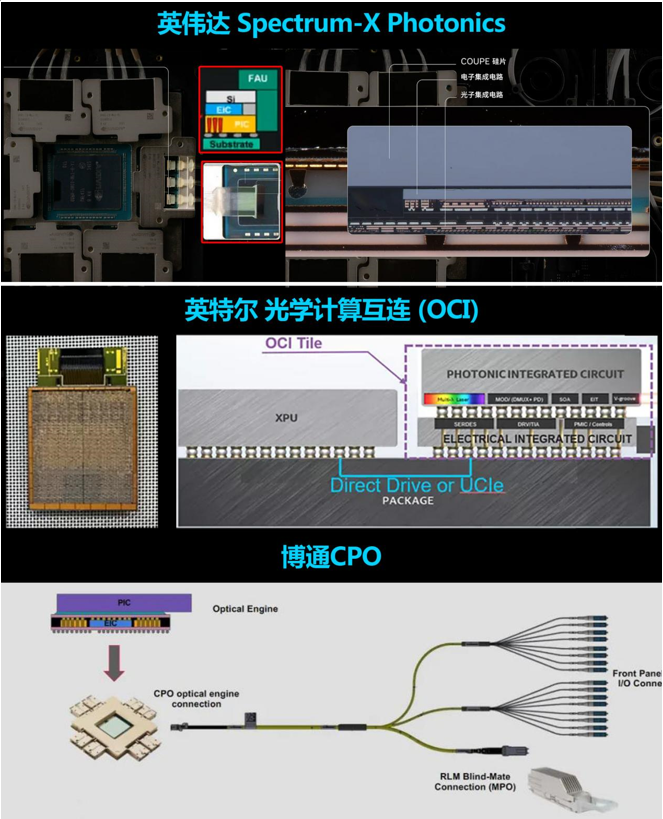
在CPO封装制造中,EIC和PIC的集成是最关键的步骤之一,英伟达的Spectrum-X Photonics CPO交换机,采用台积电的COUPE技术(基于混合键合的3D封装技术);英特尔的光学计算互联(OCI)的CPO,采用硅中介层+TCB(热压键合)实现光电集成;博通BCM78909的CPO由台积电代工制造,采用的也是TCB(基于硅中介层的 2.5D 封装技术)。
TCB是目前CPO封装最成熟,成本最低的方案,Fluxless的TCB,去除了传统TCB使用Flux可能给光芯片带来助焊剂污染的可能,是未来CPO量产的核心设备。
CPO量产的核心挑战
尽管 CPO 在性能和成本方面优势显著,但行业在量产过程中仍需解决诸多挑战:
1. 首先是封装工艺复杂。CPO 系统需要高度复杂的先进封装技术,如热压键合(TCB)或混合键合,还需实现光学耦合的精密集成、严格的测试流程和良率管理,以确保系统可靠性。
2. 其次是硅兼容性问题。业界存在疑问:基于硅的光子集成电路(PIC),尤其是光电二极管(PD),能否在性能上实现足够突破,与采用磷化铟(InP)光电二极管的传统光模块竞争。
3. 再者是耐久性与热管理。由于所有光学组件将紧密封装在交换机 ASIC/xPU 系统内部,组件必须能承受高温并保持稳定性能,这对耐久性和热管理提出了极高要求。
4. 最后是可靠性问题。光引擎(OE)与 ASIC 紧密集成在同一 PCB / 基板上(未来甚至可能集成在中介层上),这意味着生产或运行中只要单个光引擎失效,整个封装(包括高成本的交换机或 xPU 芯片)就可能报废。因此,封装前对光引擎的测试至关重要,直接影响产品良率和可靠性。
TCB工艺为何成为首选?
TCB工艺以精准控温、亚微米精度、可控应力三大优势,成为EIC和PIC异构集成的首选可行方案,完美应对复杂封装工艺的挑战:
1. 低温键合(解决热损伤):邦头精准温度控制在150~200℃(远低于回流焊的250℃+),仅对凸点局部加热,避免整体基板升温,保护热敏光学元件。
2. 亚微米级贴装精度(光耦合关键):实时光学对准+闭环控制,动态调整贴装头位置,补偿热漂移,实现超高精度光学对准(亚微米级),CPO实现高效光耦合的关键。
3. 无助焊剂工艺(避免光学污染):采用无助焊剂工艺,避免光学污染,光学界面保持极高的洁净度。
4. 应力管理(解决CTE失配):精准力控,施加5~50N柔性压力,避免脆性PIC破裂;凸点材料创新,采用低模量焊料(如In/Sn合金)或铜混合键合,吸收应力。
5. 高密度互连:支持微凸块间距低至10μm以下,实现电芯片与硅光芯片之间大量的电信号连接(I/O数量多)。
6. 良好的材料兼容性:CPO封装涉及多种材料(硅、III-V族化合物半导体、玻璃、有机基板、金属等),互连工艺需要与这些材料兼容。

普莱信智能——中国TCB设备的引领者
普莱信推出的Loong系列TCB热压键合机打破国际垄断,最新推出的Fluxless TCB设备Loong Advance,适用于CPO、HBM、CoWoS、oDSP等TCB工艺,为客户提供覆盖研发、打样至量产的全闭环支持,迄今为止,普莱信已经为10余家客户完成TCB的打样,涉及到2.5D,3D,CPO等多个领域,是国产唯一一家能为客户提供工艺开发,打样和设备的国产厂家。普莱信的DA403COB/COC超高精度固晶机,目前已大批量供货全球最大的光模厂商,Fluxless TCB设备Loong Advance将助力国产CPO厂商实现规模化量产和降本增效。随着CPO向3.2T+时代迈进,TCB将进一步融合激光加热、铜直键合(Cu-Cu Direct Bonding)等技术,作为下一代CPO的关键技术,将支撑光电芯片的“摩尔定律”延续。
CPO作为一种革命性的光电集成技术,将传统分离的光学组件包括电子集成电路(EIC) 、光子集成电路(PIC)集成在同一封装基板或中介层(Interposer)上,便构成了光引擎(OE),它被安装在基板上的 ASIC 芯片周围。相较于传统可插拔光模块,CPO将能耗降低50%、延迟压至1纳秒内、信号完整性优化了18dB(63倍)、支持1.6T以上超高带宽、更高集成度等优势,正在高速数据中心、人工智能计算集群和通信网络等领域掀起变革浪潮。
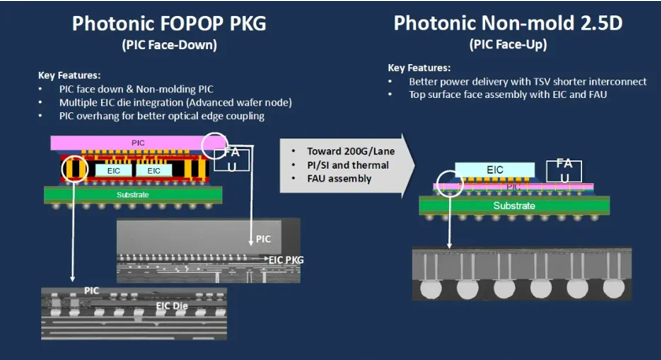
据权威机构预测,全球CPO市场规模从2024年4600万美元增至2030年81亿美元(年复合增长率137%)。
在当前的早期发展阶段,CPO面临热管理(3D堆叠温度>85℃)、封装良率(<85%)、成本高等瓶颈。CPO模块成本数千美元,封装制造占总成本的30%-50%+,需规模化降本,随着技术成熟和量产,这个比例有望大幅下降。
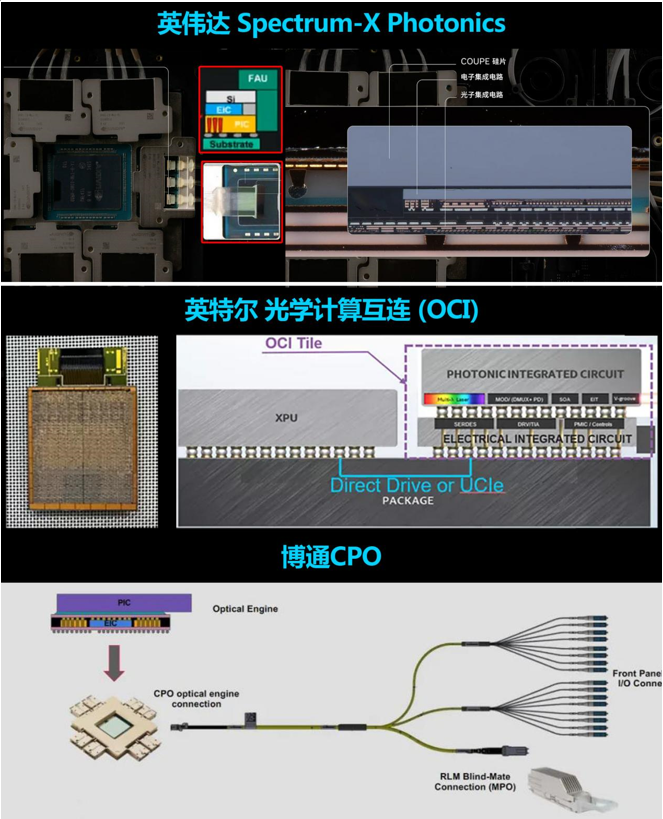
在CPO封装制造中,EIC和PIC的集成是最关键的步骤之一,英伟达的Spectrum-X Photonics CPO交换机,采用台积电的COUPE技术(基于混合键合的3D封装技术);英特尔的光学计算互联(OCI)的CPO,采用硅中介层+TCB(热压键合)实现光电集成;博通BCM78909的CPO由台积电代工制造,采用的也是TCB(基于硅中介层的 2.5D 封装技术)。
TCB是目前CPO封装最成熟,成本最低的方案,Fluxless的TCB,去除了传统TCB使用Flux可能给光芯片带来助焊剂污染的可能,是未来CPO量产的核心设备。
CPO量产的核心挑战
尽管 CPO 在性能和成本方面优势显著,但行业在量产过程中仍需解决诸多挑战:
1. 首先是封装工艺复杂。CPO 系统需要高度复杂的先进封装技术,如热压键合(TCB)或混合键合,还需实现光学耦合的精密集成、严格的测试流程和良率管理,以确保系统可靠性。
2. 其次是硅兼容性问题。业界存在疑问:基于硅的光子集成电路(PIC),尤其是光电二极管(PD),能否在性能上实现足够突破,与采用磷化铟(InP)光电二极管的传统光模块竞争。
3. 再者是耐久性与热管理。由于所有光学组件将紧密封装在交换机 ASIC/xPU 系统内部,组件必须能承受高温并保持稳定性能,这对耐久性和热管理提出了极高要求。
4. 最后是可靠性问题。光引擎(OE)与 ASIC 紧密集成在同一 PCB / 基板上(未来甚至可能集成在中介层上),这意味着生产或运行中只要单个光引擎失效,整个封装(包括高成本的交换机或 xPU 芯片)就可能报废。因此,封装前对光引擎的测试至关重要,直接影响产品良率和可靠性。
TCB工艺为何成为首选?
TCB工艺以精准控温、亚微米精度、可控应力三大优势,成为EIC和PIC异构集成的首选可行方案,完美应对复杂封装工艺的挑战:
1. 低温键合(解决热损伤):邦头精准温度控制在150~200℃(远低于回流焊的250℃+),仅对凸点局部加热,避免整体基板升温,保护热敏光学元件。
2. 亚微米级贴装精度(光耦合关键):实时光学对准+闭环控制,动态调整贴装头位置,补偿热漂移,实现超高精度光学对准(亚微米级),CPO实现高效光耦合的关键。
3. 无助焊剂工艺(避免光学污染):采用无助焊剂工艺,避免光学污染,光学界面保持极高的洁净度。
4. 应力管理(解决CTE失配):精准力控,施加5~50N柔性压力,避免脆性PIC破裂;凸点材料创新,采用低模量焊料(如In/Sn合金)或铜混合键合,吸收应力。
5. 高密度互连:支持微凸块间距低至10μm以下,实现电芯片与硅光芯片之间大量的电信号连接(I/O数量多)。
6. 良好的材料兼容性:CPO封装涉及多种材料(硅、III-V族化合物半导体、玻璃、有机基板、金属等),互连工艺需要与这些材料兼容。

普莱信智能——中国TCB设备的引领者
普莱信推出的Loong系列TCB热压键合机打破国际垄断,最新推出的Fluxless TCB设备Loong Advance,适用于CPO、HBM、CoWoS、oDSP等TCB工艺,为客户提供覆盖研发、打样至量产的全闭环支持,迄今为止,普莱信已经为10余家客户完成TCB的打样,涉及到2.5D,3D,CPO等多个领域,是国产唯一一家能为客户提供工艺开发,打样和设备的国产厂家。普莱信的DA403COB/COC超高精度固晶机,目前已大批量供货全球最大的光模厂商,Fluxless TCB设备Loong Advance将助力国产CPO厂商实现规模化量产和降本增效。随着CPO向3.2T+时代迈进,TCB将进一步融合激光加热、铜直键合(Cu-Cu Direct Bonding)等技术,作为下一代CPO的关键技术,将支撑光电芯片的“摩尔定律”延续。
责任编辑:Ace
相关文章
-

- 半导体行业观察
-

- 摩尔芯闻